激光退火是绝缘栅双极型晶体管(IGBT)反面工艺的重要过程。对离子注入后的硅基IGBT 圆片反面进行激光快速退火,完成激活深度,有用修正离子注入损坏的晶格结构。跟着IGBT技能发展和薄片加工工艺研制的需求,IGBT反面退火越来越多使用激光退火技能。
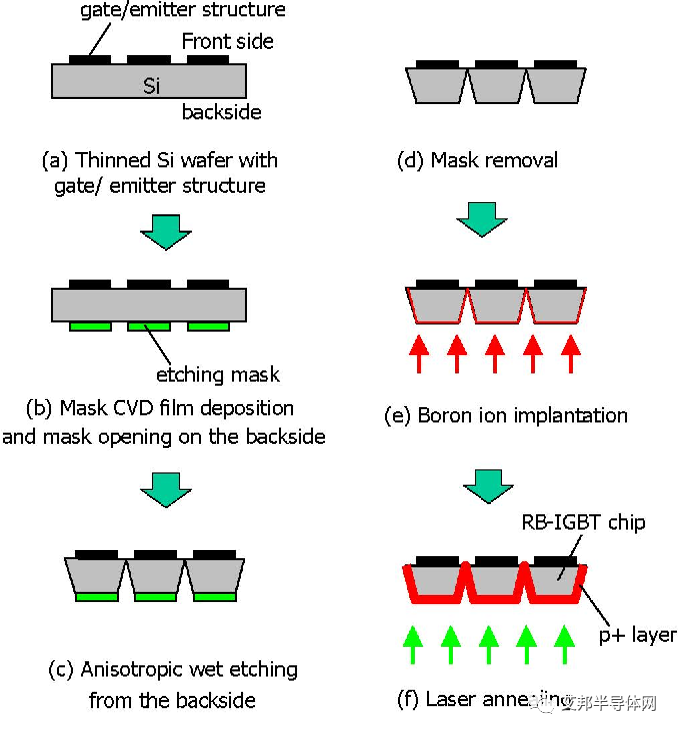
因为硅片正面金属铝的存在,此处的退火工艺一定要确保硅片正面温度要小于500℃,因而用炉管工艺来激活时温度有必要低于500℃(一般挑选400-450℃)。但在这一温度范围内,注入离子的激活率很低,对器材的功能调整构成影响。
激光退火因为能够对硅片反面进行局域加热,在硅片反面部分构成极高温,大幅度进步反面注入离子的激活率,一起坚持硅片正面在较低温度。
20世纪60年代后期和20世纪70年代初期偶然呈现过关于激光退火的报导,可是激光退火直到1971年才被创造出来。为了能够更好的确保不损害正面的器材结构,并确保反面的激活作用,从IGBT第四代之后,逐渐采取了激光退火技能替代传统热退火技能。
激光退火的原理是用激光束照耀半导体外表,在照耀区内发生极高的温度,使晶体的损害得到修正,并消除位错的办法。它能有用地消除离子注入所发生的晶格缺点,一起因为加热时刻极短(约为一般热退火的百万分之一),可防止损坏集成电路的浅结电导率和其他结特性。
激光退火工艺能够有用修正离子注入损坏的晶格结构,取得比传统退火方法更好的离子激活功率和激活深度,且不损害硅片的正面器材,从而在IGBT制造的完好过程中得到业界的广泛重视和使用。
*博客内容为网友个人发布,仅代表博主个人自己的观念,如有侵权请联络工作人员删去。